Die Arbeit beschäftigt sich mit der Reinigung und Gasphasenepitaxie in einem Ultrahochvakuum-Mehrkammersystem (UHV-Mehrkammersystem) für zukünftige CMOS-Technologien. Der Schwerpunkt der Arbeit liegt dabei in der Entwicklung von Prozessen für das "Kontakt- Engineering" von Source- und Drain (S/D) für sub-100 nm MOSFETs. Mögliche Anwendungen liegen in der Implementierung von erhöhten S/D-Kontakten zur Erniedrigung der Source/Drain- Anschusswiderstände oder dem epitaktischen Auffüllen von S/D-Extension-Gebieten zur Minimierung von Kurzkanaleffekten. Im Rahmen dieser Arbeit wurde zum ersten Mal in einem Clustertool eine Wasserstoff- Plasmareinigung zur in-situ-LT-Reinigung von planaren oder vorstrukturierten Substraten mit UHV-CVD-Epitaxie kombiniert. Die Verwendung eines SiH4/GeH4-Prekursorengemisches erlaubt es, bei den typischen Prozessdrücken von 10?4 mbar bis 10?2 mbar auch ohne Chlorchemie selektive Abscheidung von Silizium und Silizium-Germanium-Legierungen zu gewährleisten. Insgesamt lässt sich damit ein Gesamtprozess inklusive Vorreinigung und selektiver Abscheidung (SEG) bei Temperaturen T ? 800 °C für die Si-UHV-CVD und T ? 600 °C für die SiGe-UHV-CVD etablieren. Die technologischen Rahmenbedingungen, welche in der Entwicklung eines selektiven LT-Epitaxieprozesses ohne chlorierte Prekursoren in Kombination mit einer in-situ-LT-Reinigung in einem Clustertool gegeben sind, wurden damit voll erfüllt.Reinigung: Es wurden grundlegende Untersuchungen von verschiedenen UHV-kompatiblen Reinigungsverfahren, die sich durch unterschiedliche Temperaturbereiche und die Reinigungseffizienz unterscheiden, durchgeführt. Ergebnisse aus Untersuchungen zur thermischen Desorption im UHV (HT-Reinigung) konnten dabei auf die Wasserstoff-Plasmareinigung (LT-Reinigung) und die thermische Desorption in reaktiven Gasen (LT-Reinigung) umgesetzt werden. Das Hauptaugenmerk lag jeweils im Nachweis von Sauerstoff-, Kohlenstoff- und Stickstoff-Verunreinigungen. Es zeigt sich, dass die thermische Desorption (bei technologisch relevanten Temperaturen) im UHV äquivalent zur thermischen Desorption in Inertgasumgebungen, z. B. dem sog. H2-bake, ist. Die H2-Plasmareinigung ist mit einer maximalen Prozesstemperatur von ca. 225 °C eine LT-Reinigung. Es konnte erstmals nachgewiesen werden, dass die Ätzwirkung des Wasserstoffplasmas auf Oxid durch die Sputterwirkung von Ar -Ionen initiiert wird. Durch Ionenbeschuss wird das Oxid geschädigt und die obersten "Si?O"-Bindungen werden aufgebrochen. Durch die H-Radikale erfolgt schließlich ein ganzflächiger Oxidabtrag.Gasphasenepitaxie: Untersuchungen zur Morphologie von SiGe-Schichten haben gezeigt, dass sich im Gegensatz zur thermischen Desorption bei 900 °C mit H2-Plasmareinigung als Vorreinigung schon bei 500 °C mittels UHV-CVD glatte SiGe- Schichten herstellen lassen. Aufbauend auf den Ergebnissen zur ganzflächigen Epitaxie von Si und SiGe mittels UHVCVD wurde die Selektivität bezüglich vorstrukturierter Oxid- und Nitridsubstrate untersucht. Die Inkubationszeit für das Poly-Wachstum auf Nitrid ist sehr viel geringer als für die Poly-Nukleation auf Oxid. Eine selektive Abscheidung von Si in Si-Fenstern von vorstrukturierten Nitridsubstraten ist für UHV-CVD bei 800 °C und thermischer Desorption als Vorreinigung daher nicht möglich. Weitere Untersuchungen haben gezeigt, dass die Inkubationszeit vom Silan- bzw. Germanpartialdruck abhängt. Zusätzlich wird das Nukleationsverhalten bei UHV-CVD und H2-Plasmareinigung als Vorreinigung durch die Plasmaparameter, z.B. der Plasmadauer, bestimmt. Prozesstechnisch kommt es bei Abscheidung im massentransportabhängigen Temperaturbereich bei Si-UHV-CVD (z. B. bei 800 °C) unabhängig von der Vorreinigung zu bekannten Effekten, wie dem "chemischen Loading-Effekt" und dem Facettenwachstum von Si(111) und Si(311)-Mesaflächen. Beide Effekte sind prinzipiell unerwünscht. Zur elektrischen Charakterisierung der Kristallqualität von selektiv gewachsenen i-Si-Schichten wurden SEG-Mesen im Si-Fenster eines vorstrukturierten Oxidsubstrats gewachsen und zu einer nip-Diode prozessiert. Die bestimmte Volumendefektdichte entspricht der Dichte von ganzflächig abgeschiedenen intrinsischen Siliziumschichten. Glatte SiGe-Schichten mit einer ausreichenden maximalen selektiven Schichtdicke von ca. 30 nm konnten schließlich mit SiGe-UHV-CVD bei 500 °C in Kombination mit der H2-Plasmareinigung als Vorreinigung hergestellt werden. Damit steht ein UHV-kompatibler Prozess zur Herstellung von vertikal erhöhten Source/Drain-Gebieten in planaren MOSFETs zur Verfügung. LP-CVD ist für die Abscheidung selektiver SiGe-Schichten nicht geeignet, weshalb bei industriellen RP-CVD-Prozessen SEG nur mit chlorierten Prekursoren bzw. durch Beimischung von HCl als Ätzgas funktioniert. Die Anwendung des Prozesses zur Herstellung eines epitaktischen Source/Drain-Anschlussgebietes eines MOSFETs der 90 nm Technologie wurde ebenfalls versucht. Das Ätzen der S/D-Extension erfolgt durch ein sequentielles H2-Plasmaätzen des Oxids mit anschließendem Si-Ätzen. Das Wiederauffüllen der freigeätzten Extensiongebiete ist aufgrund der gezeigten Selektivität zum Spacer-Material möglich.Abstract The dissertation deals with cleaning and gas phase epitaxy in an ultra high vacuum multi chamber system (UHV cluster tool) for future CMOS technologies. The emphasis of the work is the development and discussion of processes for the "contact engineering" of source and drain (S/D) for sub-100 nm MOSFETs. Appropriate applications focus on the implementation of elevated S/D contacts to reduce S/D contact resistances or an epitaxial refilling of S/D extensions to minimize short channel effects. In the context of this work for the first time a hydrogen plasma cleaning for the in-situ-LT-cleaning of planar or pre-structured substrates was combined with UHV-CVD epitaxy in a cluster tool. The use of a SiH4/GeH4 precursor gas mixture with typical process pressures of 10-4 mbar to 10-2 mbar ensures selective epitaxial growth of silicon and silicon germanium alloys even without chlorine chemistry. As a conclusion one can establish a full process including pre-cleaning and selective epitaxial growth (SEG) at temperatures T<800 °C for Si-UHV-CVD and T<600 °C for SiGe-UHV CVD. The technological conditions, which are given in the development of a selective LT epitaxy process without chlorinated precursors in combination with a in situ LT cleaning in a cluster tool, were fully fulfilled.Cleaning: Fundamental investigations of different UHV compatible cleaning methods, which differ by temperature ranges and cleaning efficiencies, were accomplished. Results from investigations for thermal desorption in UHV (HT cleaning) could be transferred to the hydrogen plasma cleaning (LT cleaning) and the thermal desorption in reactive gases (LT cleaning). In each case the focus was in the proof of oxygen-, carbon and nitrogen impurities. It is shown, that the thermal desorption (at technologically relevant temperatures) in UHV is equivalent to the thermal desorption in inert gas environments, e.g.. the H2-bake. The hydrogen plasma cleaning with a max. process temperature of approx. 225 °C is an appropriate LT cleaning method. It could be proven for the first time, that the etching reaction of the hydrogen plasma on oxide is initiated by the sputtering effect of argon ions. By ion bombardment the oxide will become damaged and "Si-O" bindings on top of the surface will be broken. With assistance of hydrogen radicals a total surface oxide erosion finally takes place.Gas Phase Epitaxy: Investigations of the morphology of SiGe layers showed that in contrast to the thermal desorption at 900 °C the H2-plasma cleaning as substrate cleaning smooth SiGe layers grown by means of UHV CVD at 500 °C can be deposited. Based on the results to areal epitaxy of Si and SiGe by means of UHV-CVD the selectivity to pre-structured oxide and nitride substrates was examined. The incubation time for poly growth on nitride is much smaller than for the poly nucleation on oxide. The selective epitaxial growth of Si in silicon windows of pre-structured nitride substrates is not possible for thermal desorption as pre-cleaning and UHV-CVD at 800 °C. Further investigations showed that the incubation time depends on the silane and/or germane partial pressure. Additionally the nucleation behaviour for UHV-CVD and hydrogen plasma cleaning as pre-cleaning is determined by the plasma parameters, e.g. the plasma duration. There are well-known effects for the Si-UHV-CVD in the mass transport limited temperature range (e.g. at 800 °C), independently from pre-cleaning, like the "chemical loading effect" and facet growth on Si(111) and Si(311)-mesa surfaces. Both effects are in principle unwanted. For the electrical characterization of the crystal quality of selectively grown intrinsic silicon layers SEG mesa structures were grown in silicon windows of pre-structured oxide substrates and processed to nip-diodes. Measured volume defect densities correspond to the densities of areal grown i-Si layers. Smooth SiGe layers with a sufficient maximum selective layer thickness of approx. 30 nm could be finally manufactured with SiGe-UHV-CVD at 500 °C in combination with H2-plasma cleaning as substrate pre-cleaning. Thus there is a UHV compatible process for elevated source/drains in planar MOSFETs available. LP-CVD is not appropriate for selective grown SiGe layers and therefore for industrial RP-CVD processes SEG works only by use of chlorinated precursors and/or by admixture of HCl as corrosive gas. The application of the process for the production of a epitaxial source/drain extensions of a MOSFETs for the 90 nm technology node was also tried. Etching of the S/D extension was done via a sequential H2-plasma etch process of the native oxide with a following silicon etch. Refilling of the removed silicon of the extension region with SiGe is possible due to the selectivity shown to the spacer mater
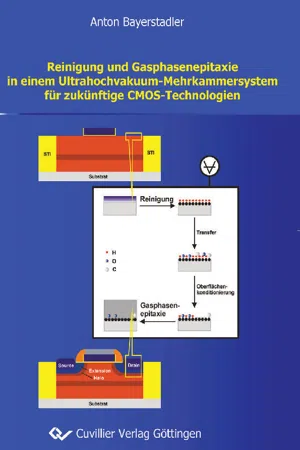
- 323 pages
- English
- PDF
- Available on iOS & Android
eBook - PDF
About this book
Trusted by 375,005 students
Access to over 1.5 million titles for a fair monthly price.
Study more efficiently using our study tools.
Information
Print ISBN
9783867279840
Edition
1